- 品牌
- PVD
- 型号
- 齐全
我们的标准脉冲激光沉积(PLD)系统是面向广大科研用户的高性价比解决方案。其主要设计理念是在保证关键性能指标达到研究级水准的同时,较大限度地优化成本。系统配备了六靶位自动切换装置,允许用户在一次真空循环中连续沉积多种不同材料,构建复杂的异质结或梯度薄膜。基板加热器采用特殊设计的铂金加热片,不仅能在高真空下稳定工作,还能在300毫托的氧气氛围中,将2英寸基板加热至1200摄氏度,这对于生长需要高温氧化环境的钙钛矿氧化物等关键功能材料至关重要。系统的基础真空优于5E-8帕斯卡,确保了薄膜生长前基板表面的整体洁净,是获得高质量单晶外延薄膜的根本保证。测温端子数据偏差时,需重新校准,确保温度监测准确。旋转基片台外延系统基板温度

辅助表征设备的布局建议。为了提高科研效率,建议将PLD/MBE系统与必要的离线表征设备就近放置或通过真空互联。例如,可以将一台X射线衍射仪(XRD)和一台原子力显微镜(AFM)安置在相邻的实验室。这样,生长出的样品可以快速、方便地进行晶体结构和表面形貌的分析,从而及时反馈指导下一次生长实验的参数调整,形成一个“生长-表征-优化”的高效闭环研究流程。激光安全防护是实验室设计的重中之重。必须为整个PLD系统区域制定明确的激光安全管理制度。设备应放置在有互锁装置的封闭区域内,或者至少为激光光路安装全封闭的防护罩。在激光可能出射的区域(如真空腔的观察窗)张贴醒目的激光警告标志。所有操作人员必须强制接受激光安全培训,并在操作时佩戴与激光波长匹配的防护眼镜。实验室门口应安装工作状态指示灯,明确显示激光器是否正在运行。旋转基片台外延系统基板温度与普通 MBE 系统比,该 PLD 系统性价比更高,适合研究级应用。
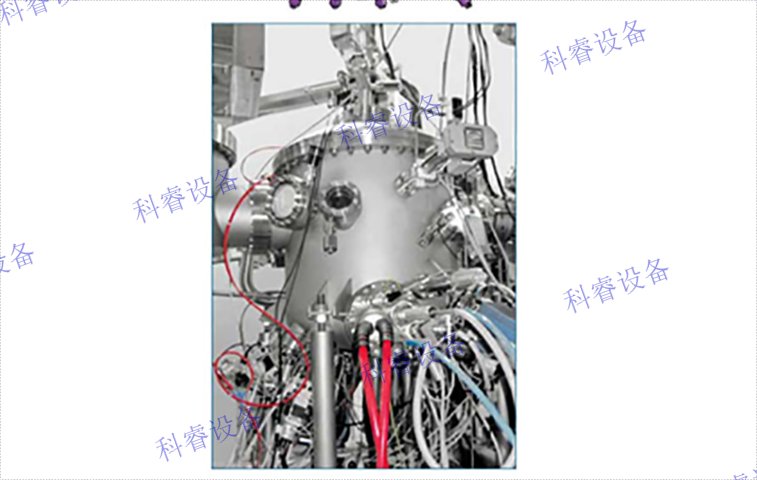
排气系统是维持超高真空环境的动力源泉。我们系统采用“分子泵+干式机械泵”的组合方案。干式机械泵作为前级泵,无需使用真空油,彻底避免了油蒸汽对腔室的污染,实现了洁净抽气。分子泵则串联其后,利用高速旋转的涡轮叶片对气体分子进行动量传递,将其压缩并排向前级泵,从而在生长腔室获得高真空和超高真空。这种组合抽气系统运行稳定、维护简单,且能提供洁净无油的真空环境,非常适合于对污染极其敏感的半导体材料和氧化物材料的生长。
沉积过程中的参数设置直接影响薄膜的质量和性能,需要根据实验目的和材料特性进行精确调整。温度是一个关键参数,基板温度可在很宽的范围内进行控制,从液氮温度(LN₂)达到1400°C。在生长半导体材料时,不同的材料和生长阶段对温度有不同的要求。例如,生长砷化镓(GaAs)薄膜时,适宜的基板温度通常在500-600°C之间,在此温度下,原子具有足够的能量在基板表面扩散和排列,有利于形成高质量的晶体结构。若温度过低,原子活性不足,可能导致薄膜结晶度差,出现缺陷;若温度过高,可能会使薄膜的应力增大,甚至出现开裂等问题。系统提供选配的基板刻蚀与预处理功能。
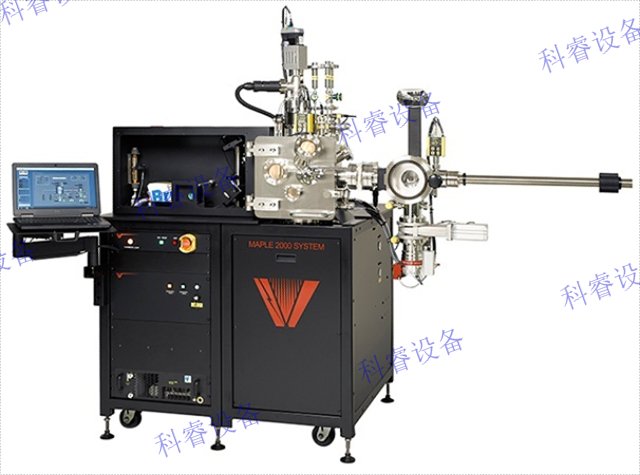
基板在沉积过程中的旋转功能对于获得成分和厚度高度均匀的薄膜至关重要。在PLD过程中,激光烧蚀产生的等离子体羽辉(Plume)具有一定的空间分布,通常呈中心密度高、边缘密度低的余弦分布。如果基板静止不动,沉积出的薄膜将会中间厚、边缘薄,形成一道“山峰”。通过让基板绕其中心轴匀速旋转,薄膜的每一个点都会周期性地经过羽辉的中心和边缘,对沉积速率进行时间上的平均,从而有效地补偿了羽辉空间分布的不均匀性,从而获得厚度变化率小于±2%的优异均匀性。2 英寸基板规格,适合多数小型研究级薄膜制备实验。旋转基片台外延系统基板温度
多腔室设计支持复杂的多层异质结构外延生长。旋转基片台外延系统基板温度
本产品与CVD技术对比,CVD(化学气相沉积)技术通过化学反应在气相中生成固态薄膜,与本产品在多个方面存在明显差异。在反应条件上,CVD通常需要在较高温度下进行,一般在800-1100°C,这对一些对温度敏感的材料和衬底来说,可能会导致材料性能改变或衬底变形。本产品的沉积过程温度可在很宽的范围内控制,从液氮温度到1400°C,能满足不同材料的生长需求,对于一些不能承受高温的材料,可在低温环境下进行沉积,避免材料性能受损。旋转基片台外延系统基板温度
科睿設備有限公司是一家有着先进的发展理念,先进的管理经验,在发展过程中不断完善自己,要求自己,不断创新,时刻准备着迎接更多挑战的活力公司,在上海市等地区的化工中汇聚了大量的人脉以及**,在业界也收获了很多良好的评价,这些都源自于自身的努力和大家共同进步的结果,这些评价对我们而言是比较好的前进动力,也促使我们在以后的道路上保持奋发图强、一往无前的进取创新精神,努力把公司发展战略推向一个新高度,在全体员工共同努力之下,全力拼搏将共同科睿設備供应和您一起携手走向更好的未来,创造更有价值的产品,我们将以更好的状态,更认真的态度,更饱满的精力去创造,去拼搏,去努力,让我们一起更好更快的成长!
- MBE外延系统产品描述 2026-03-05
- 脉冲激光外延系统报价 2026-03-03
- 激光外延系统售后 2026-02-27
- 薄层外延系统靶材 2026-02-25
- 全自动外延系统靶盘 2026-02-24
- 全自动分子束外延系统产品尺寸 2026-02-13
- 脉冲激光沉积外延系统软件 2026-02-12
- 多腔室外延系统分子泵 2026-02-11