65、SOP(small Out-Line package)小外形封装。表面贴装型封装之一,引脚从封装两侧引出呈海鸥翼状(L字形)。材料有塑料和陶瓷两种。另外也叫SOL和DFP。SOP除了用于存储器LSI外,也***用于规模不太大的ASSP等电路。在输入输出端子不超过10~40的领域,SOP是普及**广的表面贴装封装。引脚中心距1.27mm,引脚数从8~44。另外,引脚中心距小于1.27mm的SOP也称为SSOP;装配高度不到1.27mm的SOP也称为TSOP(见SSOP、TSOP)。还有一种带有散热片的SOP。66、SOW(Small Outline Package(Wide-Jype))宽体SOP。部分半导体厂家采用的名称。薄型QFP。指封装本体厚度为1.4mm的QFP,是日本电子机械工业会根据制定的新QFP外形规格所用的名称。江苏本地集成电路市价

球形触点阵列,表面贴装型封装之一。在印刷基板的背面按阵列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封。也称为凸点阵列载体(PAC)。引脚可超过200,是多引脚LSI 用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm的360引脚BGA*为31mm见方;而引脚中心距为0.5mm的304 引脚QFP为40mm见方。而且BGA不用担心QFP那样的引脚变形问题(见有图所示)。无锡标准集成电路图片例如5G手机、数码相机、电脑CPU、数字电视的逻辑控制和重放的音频信号和视频信号)。
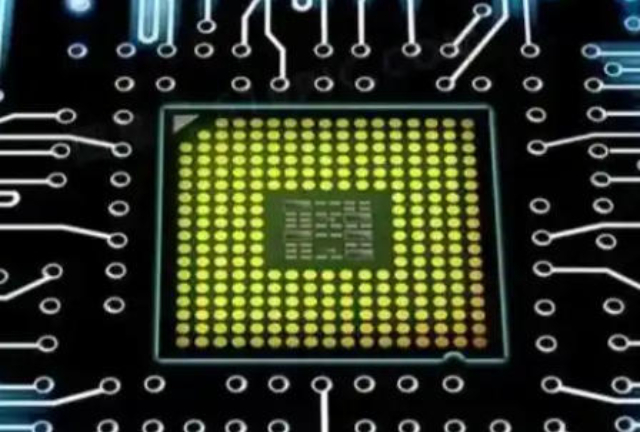
1990年-2000年:以908工程、909工程为重点,以CAD为突破口,抓好科技攻关和北方科研开发基地的建设,为信息产业服务,集成电路行业取得了新的发展。集成电路产业是对集成电路产业链各环节市场销售额的总体描述,它不仅*包含集成电路市场,也包括IP核市场、EDA市场、芯片代工市场、封测市场,甚至延伸至设备、材料市场。集成电路产业不再依赖CPU、存储器等单一器件发展,移动互联、三网融合、多屏互动、智能终端带来了多重市场空间,商业模式不断创新为市场注入新活力。目前中国集成电路产业已具备一定基础,多年来中国集成电路产业所聚集的技术创新活力、市场拓展能力、资源整合动力以及广阔的市场潜力,为产业在未来5年~10年实现快速发展、迈上新的台阶奠定了基础。
美国Olin公司开发的一种QFP封装。基板与封盖均采用铝材,用粘合剂密封。在自然空冷条件下可容许2.5W~2.8W的功率。日本新光电气工业公司于1993年获得特许开始生产。31、MSP(mini square package)QFI的别称(见QFI),在开发初期多称为MSP。QFI是日本电子机械工业会规定的名称。34、OPMAC(over molded pad array carrier)模压树脂密封凸点陈列载体。美国Motorola公司对模压树脂密封BGA采用的名称(见BGA)。32、P-(plastic)表示塑料封装的记号。如PDIP表示塑料DIP。33、PAC(pad array carrier)触点陈列封装。即在底面制作有阵列状态坦电极触点的封装。

外,由于引线的阻抗小,对于高速LSI是很适用的。但由于插座制作复杂,成本高,90年代基本上不怎么使用。预计今后对其需求会有所增加。24、LOC(lead on chip)芯片上引线封装。LSI封装技术之一,引线框架的前端处于芯片上方的一种结构,芯片的中心附近制作有凸焊点,用引线缝合进行电气连接。与原来把引线框架布置在芯片侧面附近的结构相比,在相同大小的封装中容纳的芯片达1mm左右宽度。25、LQFP(low profile quad flat package)薄型QFP。指封装本体厚度为1.4mm的QFP,是日本电子机械工业会根据制定的新QFP外形规格所用的名称。模压树脂密封凸点陈列载体。美国Motorola公司对模压树脂密封BGA采用的名称(见BGA)。南京质量集成电路图片
集成电路按应用领域可分为标准通用集成电路和集成电路。江苏本地集成电路市价
26、L-QUAD陶瓷QFP之一。封装基板用氮化铝,基导热率比氧化铝高7~8倍,具有较好的散热性。封装的框架用氧化铝,芯片用灌封法密封,从而抑制了成本。是为逻辑LSI开发的一种封装,在自然空冷条件下可容许W3的功率。现已开发出了208引脚(0.5mm中心距)和160引脚(0.65mm中心距)的LSI逻辑用封装,并于1993年10月开始投入批量生产。27、MCM(multi-chip module)多芯片组件。将多块半导体裸芯片组装在一块布线基板上的一种封装。根据基板材料可分为MCM-L,MCM-C 和MCM-D三大类。MCM-L是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。 MCM-C是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使用多层陶瓷基板的厚膜混合IC类似。两者无明显差别。布线密度高于MCM-L。江苏本地集成电路市价
无锡大嘉科技有限公司在同行业领域中,一直处在一个不断锐意进取,不断制造创新的市场高度,多年以来致力于发展富有创新价值理念的产品标准,在江苏省等地区的汽摩及配件中始终保持良好的商业口碑,成绩让我们喜悦,但不会让我们止步,残酷的市场磨炼了我们坚强不屈的意志,和谐温馨的工作环境,富有营养的公司土壤滋养着我们不断开拓创新,勇于进取的无限潜力,大嘉科技有限公司供应携手大家一起走向共同辉煌的未来,回首过去,我们不会因为取得了一点点成绩而沾沾自喜,相反的是面对竞争越来越激烈的市场氛围,我们更要明确自己的不足,做好迎接新挑战的准备,要不畏困难,激流勇进,以一个更崭新的精神面貌迎接大家,共同走向辉煌回来!
26、L-QUAD陶瓷QFP之一。封装基板用氮化铝,基导热率比氧化铝高7~8倍,具有较好的散热性。封...
【详情】56、SIP(single in-line package)单列直插式封装。引脚从封装一个侧面引出,...
【详情】集成电路,英文为Integrated Circuit,缩写为IC;顾名思义,就是把一定数量的常用电子...
【详情】3.影碟机用集成电路有系统控制集成电路、视频编码集成电路、MPEG解码集成电路、音频信号处理集成电路...
【详情】65、SOP(small Out-Line package)小外形封装。表面贴装型封装之一,引脚从封...
【详情】J形引脚小外型封装。表面贴装型封装之一。引脚从封装两侧引出向下呈J字形,故此得名。通常为塑料制品,多...
【详情】39、P-LCC(plastic teadless chip carrier)(plastic le...
【详情】成本较高。引脚中心距通常为2.54mm,引脚数从64到447左右。为了为降低成本,封装基材可用玻璃环...
【详情】集成电路具有体积小,重量轻,引出线和焊接点少,寿命长,可靠性高,性能好等优点,同时成本低,便于大规模...
【详情】2、BQFP(quad flat package with bumper)带缓冲垫的四侧引脚扁平封装...
【详情】集成度高低集成电路按集成度高低的不同可分为:SSIC 小规模集成电路(Small Scale Int...
【详情】2025年将持续推进集成电路领域标准研制。 [5]2025年2月28日,国家统计局消息:2024年集...
【详情】