MEMS制作工艺ICP深硅刻蚀:
在半导体制程中,单晶硅与多晶硅的刻蚀通常包括湿法刻蚀和干法刻蚀两种方法各有优劣,各有特点。湿法刻蚀即利用特定的溶液与薄膜间所进行的化学反应来去除薄膜未被光刻胶掩膜覆盖的部分,而达到刻蚀的目的。因为湿法刻蚀是利用化学反应来进行薄膜的去除,而化学反应本身不具方向性,因此湿法刻蚀过程为等向性。
湿法刻蚀过程可分为三个步骤:
1)化学刻蚀液扩散至待刻蚀材料之表面;
2)刻蚀液与待刻蚀材料发生化学反应;
3)反应后之产物从刻蚀材料之表面扩散至溶液中,并随溶液排出。湿法刻蚀之所以在微电子制作过程中被采用乃由于其具有低成本、高可靠性、高产能及优越的刻蚀选择比等优点。
但相对于干法刻蚀,除了无法定义较细的线宽外,湿法刻蚀仍有以下的缺点:1)需花费较高成本的反应溶液及去离子水:2)化学药品处理时人员所遭遇的安全问题:3)光刻胶掩膜附着性问题;4)气泡形成及化学腐蚀液无法完全与晶片表面接触所造成的不完全及不均匀的刻蚀 深反应离子刻蚀是 MEMS 微纳米加工中常用的刻蚀工艺,可用于制造高深宽比的微结构。现代化MEMS微纳米加工的传感器
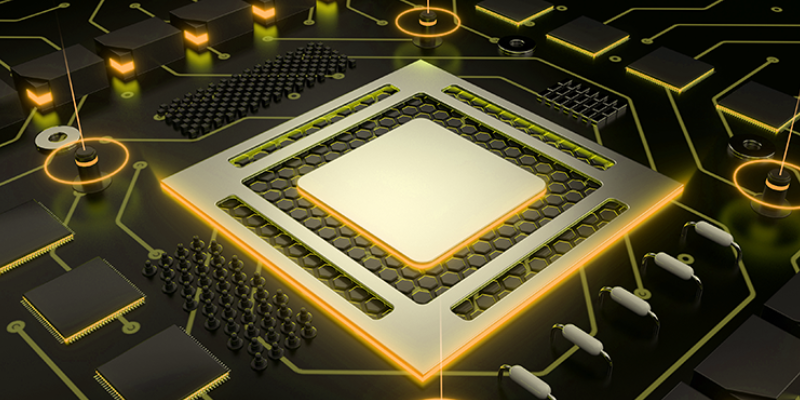
微纳结构的多图拼接测量技术:针对大尺寸微纳结构的完整表征,公司开发了多图拼接测量技术,结合SEM与图像算法实现亚微米级精度的全景成像。首先通过自动平移台对样品进行网格扫描,获取多幅局部SEM图像(分辨率5nm,视野范围10-100μm);然后利用特征点匹配算法(如SIFT/SURF)进行图像配准,误差<±2nm/100μm;通过融合算法生成完整的拼接图像,可覆盖10mm×10mm区域。该技术应用于微流控芯片的流道检测时,可快速识别全长10cm流道内的微小缺陷(如5μm以下的毛刺或堵塞),检测效率较单图测量提升10倍。在纳米压印模具检测中,多图拼接可精确分析100μm×100μm范围内的结构一致性,特征尺寸偏差<±1%。公司自主开发的拼接软件支持实时预览与缺陷标记,输出包含尺寸标注、粗糙度分析的检测报告,为微纳加工的质量控制提供了高效工具,尤其适用于复杂三维结构与大面积阵列的计量需求。新疆MEMS微纳米加工规格电子束光刻是 MEMS 微纳米加工中一种高分辨率的加工方法,能制造出极其微小的结构。
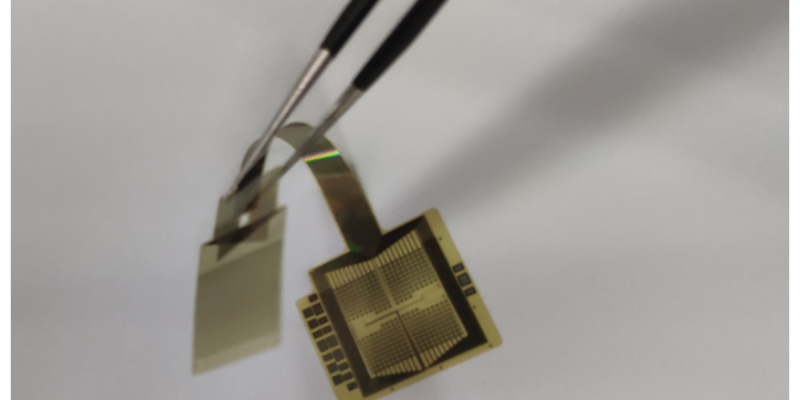
超薄石英玻璃双面套刻加工技术解析:在厚度100μm以上的超薄石英玻璃基板上进行双面套刻加工,是实现高集成度微流控芯片与光学器件的关键技术。公司采用激光微加工与紫外光刻结合工艺,首先通过CO₂激光切割实现玻璃基板的高精度成型(边缘误差<±5μm),然后利用双面光刻对准系统(精度±1μm)进行微结构加工。正面通过干法刻蚀制备5-50μm深度的微流道,背面采用离子束溅射沉积100nm厚度的金属电极层,经光刻剥离形成微米级电极阵列。针对玻璃材质的脆性特点,开发了低温键合技术(150-200℃),使用硅基粘合剂实现双面结构的密封,键合强度>3MPa,耐水压>50kPa。该技术应用于光声成像芯片时,正面微流道实现样本输送,背面电极阵列同步激发光声信号,光-电信号延迟<10ns,成像分辨率达50μm。此外,超薄玻璃的高透光性(>95%@400-1000nm)与化学稳定性,使其成为荧光检测、拉曼光谱分析等**芯片的优先基板,公司已实现4英寸晶圆级批量加工,成品率>90%,为光学微系统集成提供了可靠的制造平台。
太赫兹柔性电极的双面结构设计与加工:太赫兹柔性电极以PI为基底,采用双面结构设计,上层实现太赫兹波发射/接收,下层集成信号处理电路,解决了传统刚性太赫兹器件的便携性难题。加工工艺包括:首先在双面抛光的PI基板上,利用电子束光刻制备亚微米级金属天线阵列(如蝴蝶结、螺旋结构),特征尺寸达500nm,周期1-2μm,实现对0.1-1THz频段的高效耦合;背面通过薄膜沉积技术制备氮化硅绝缘层,溅射铜箔形成共面波导传输线,线宽控制精度±10nm,特性阻抗匹配50Ω。电极整体厚度<50μm,弯曲状态下信号衰减<3dB,适用于人体安检、非金属材料检测等场景。在生物医学领域,太赫兹柔性电极可非侵入式检测皮肤水分含量,分辨率达0.1%,检测时间<1秒,较传统电阻法精度提升5倍。公司开发的纳米压印技术实现了天线阵列的低成本复制,单晶圆(4英寸)产能达1000片以上,良率>85%,推动太赫兹技术从实验室走向便携式设备,为无损检测与生物传感提供了全新维度的解决方案。MEMS是一种现代化的制造技术。
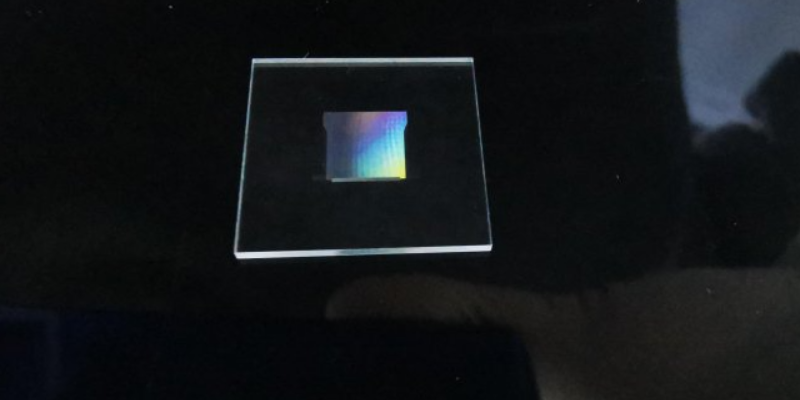
SU8微流控模具加工技术与精度控制:SU8作为负性光刻胶,广泛应用于6英寸以下硅片、石英片的单套或套刻微流控模具加工,可实现5-500μm高度的三维结构制造。加工流程包括:基板清洗→底涂处理→SU8涂胶(转速500-5000rpm,控制厚度1-500μm)→前烘→曝光(紫外光强度50-200mJ/cm²)→后烘→显影(PGMEA溶液,时间1-10分钟)。通过优化曝光剂量与显影时间,可实现侧壁垂直度>88°,**小线宽10μm,高度误差<±2%。在多层套刻加工中,采用对准标记视觉识别系统(精度±1μm),确保上下层结构偏差<5μm,适用于复杂三维流道模具制备。该模具可用于PDMS模塑成型,复制精度达95%以上,流道表面粗糙度Ra<100nm。典型应用如细胞培养芯片模具,其微柱阵列(直径50μm,高度200μm,间距100μm)可模拟细胞外基质环境,促进干细胞定向分化,细胞黏附率提升40%。公司具备从模具设计、加工到复制成型的全链条能力,支持SU8与硅、玻璃等多种基板的复合加工,为微流控芯片开发者提供了高精度、高性价比的模具解决方案。热敏柔性电极采用 PI 三明治结构,底层基板、中间电极、上层绝缘层设计确保柔韧性与导电性。特殊MEMS微纳米加工之柔性电极定制
MEMS常见的产品-压力传感器。现代化MEMS微纳米加工的传感器
微流控芯片的自动化检测与统计分析:公司建立了基于机器视觉的微流控芯片自动化检测系统,实现尺寸测量、缺陷识别与性能统计的全流程智能化。检测设备配备6MPUSB3.0摄像头与远心光学镜头,配合步进电机平移台(精度±1μm),可对芯片流道、微孔、电极等结构进行扫描。通过自研算法自动识别特征区域,测量参数包括高度(分辨率0.1μm)、周长、面积、宽度、半径等,数据重复性误差<±0.5%。缺陷检测模块采用深度学习模型,可识别<5μm的毛刺、缺口、气泡等缺陷,准确率>99%。检测系统实时生成统计报告,包含CPK、均值、标准差等质量参数,支持SPC过程控制。在PDMS芯片检测中,单芯片检测时间<2分钟,效率较人工检测提升20倍,良品率统计精度达0.1%。该系统已集成至量产产线,实现从原材料入库到成品出厂的全链路质量追溯,为微流控芯片的标准化生产提供了可靠保障,尤其适用于高精度医疗检测芯片与工业控制芯片的质量管控。现代化MEMS微纳米加工的传感器